機種 :JEOL JIB-4700F
JEOLのWebページ
設置場所 :分析計測センター214室
担当教員 :中田 大貴、郭 妍伶
担当技術職員:◯小杉 健一朗、高橋 美幸、江村 望
ピックアップ法によるTEM試料作製が可能.
三次元観察・三次元分析(EDS/EBSD)が可能.

FIBとは?FIBで何がわかるか
試料表面にGaイオンビームを照射し,試料表面の原子をスパッタリングで飛ばすことにより試料の加工を行います.二次電子像を見ながら加工位置を決定できること,ビーム径を最小数十nm径に絞ることが可能であることから,試料の特定の位置だけをナノメートルオーダーで加工できる特徴を有します.SEM観察用の断面を作製したり,TEM観察用の超薄切片を作製することができます.
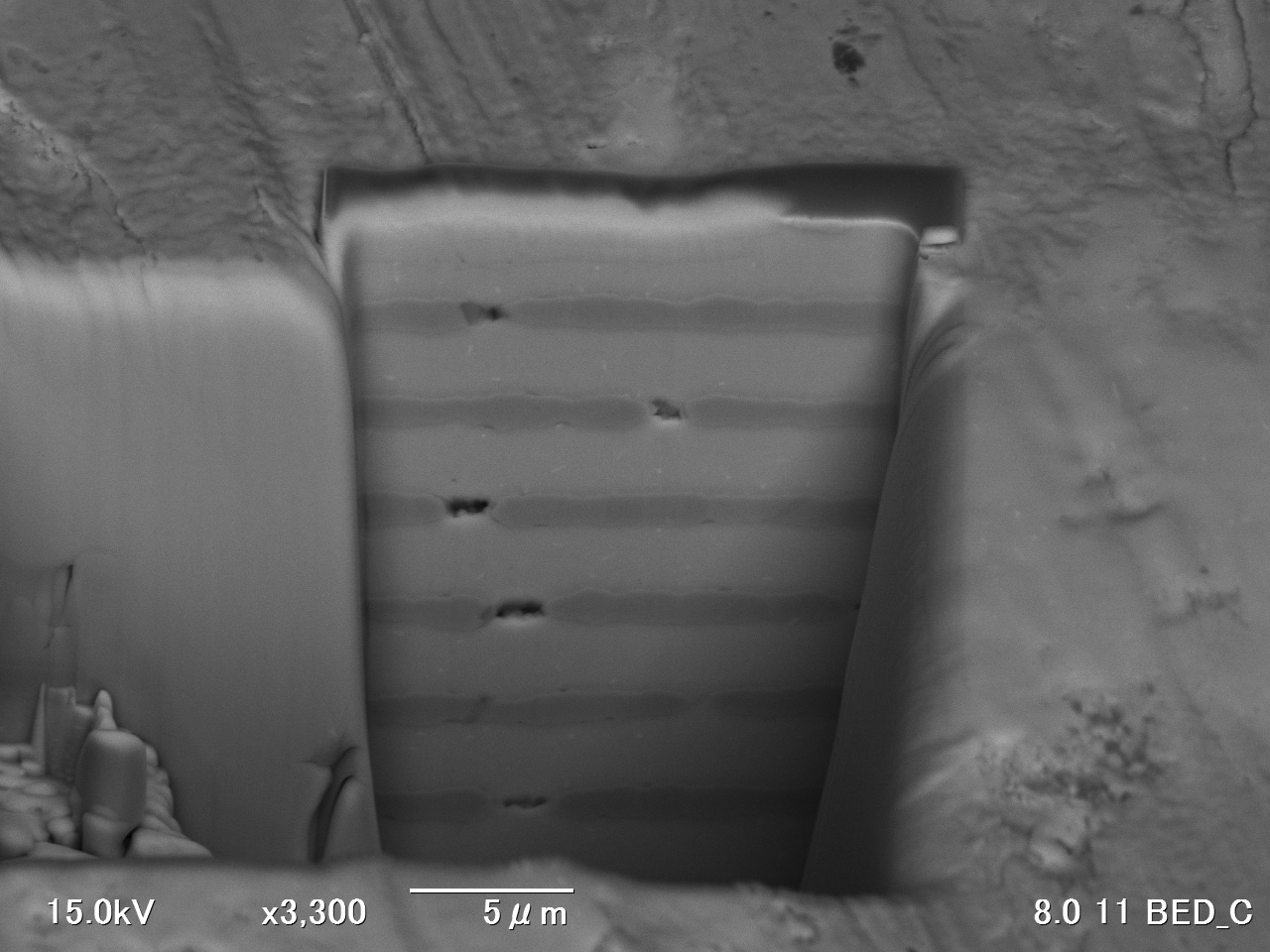
FIB/FE-SEM(JEOL JIB-4700F)の特徴
- ★断面加工と観察・分析が一台で可能
- FIBでの断面加工,FE-SEMでの断面観察を一台の機器で行うことができます.また,エネルギー分散型X線分析装置(Energy Dispersive X-ray Spectrometer, EDXあるいはEDS)としてOxford Ultim Max170を搭載しており,断面の迅速な元素分析も可能です.
- ★3次元観察・分析
- 断面加工と観察を繰返すことで多数のスライス像を得ます.これらを再構成(システムインフロンティア Stack N Viz)することにより3次元像が得られます.3D-EDS像,3D-EBSD像も得られます.
- ★ピックアップ法によるTEM試料作製
- タングステンプローブ(Oxford OmniProbe OP350)を搭載しており,試料ブロックをピックアップすることでTEM観察用の試料を作製できます.試料表面の二次電子・反射電子像,EDS・EBSDマッピング像に基づき,試料の特定の箇所からTEM試料を作製できます.

FIB/FE-SEM測定用の試料について
- 測定可能な試料
- 金属、セラミックス・ガラス
- 試料形状
- 固体(バルク、粉末)
- 試料サイズ
- 直径26 mm × 高さ10 mm
これより高さ方向に大きい試料に関してはスタッフにご相談ください. - 試料に関する注意
- 対物レンズがセミインレンズ方式であるため、粉末の磁性材料の測定はできません.
- 試料の調整方法
- 試料は試料台にカーボンテープあるいはカーボンペーストなどを用いて固定します.導電性がない試料を観察する場合,チャージアップの発生や試料へのダメージを防止するために試料表面をコーティングすることが必要です.金,白金,カーボン,オスミウムのコーティング装置が利用可能です.

JEOL JIB-4700Fの利用について
- 利用方法
- 現地利用
半遠隔利用 web会議システムによる現地スタッフとの協働的な利用
完全遠隔利用 リモートデスクトップ機能による単独での利用 - 利用補足
- 機器を直接操作(現地利用)するにはスタッフから講習を受けて操作方法を習得後、スタッフが行う技能認定試験に合格する必要があります。






